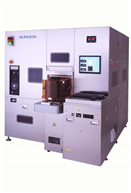
KURODA's NANOMETRO TT series can measure the flatness of 8 "/12" wafer surface with high accuracy. The surface topography of both sides of the wafer can be detected by vertical optical measurement. Suitable for DSP process management, FP shipment and IQC inspection. TT series of widely used in the world's major manufacturers of silicon wafer.
○ Vertical optical measurement method, double-side measurement.
○ Edge clamped, non-contact with wafer surface.
○ High precision air floating mechanism.
○ Edge Exclusion: 1mm.
○ On-Line application, available for process management and final inspection.
○ Open Cassette, FOUP and FOSB available.
○ Multiple measurement method:
• Flatness-SORI measuring
• Axis Measuring
Flatness parameters and shape parameters can be measured according to SEMI standard.
• Max. Thk, Min. Thk, Cen. Thk, Ave. Thk,
• GBIR(TTV), GFLR(TIR), GFLD(FPD), GF3R, GF3D,
• SORI, Bow, Warp-3P, Warp-BF,
• SBIR(LTV), SBID(SFPD), SFLR, SF3R, SF3D,
• SFQR(STIR), SFQD
• Apply to measurement of surface topography of Si, Sic and other Bare Wafer, EPI & SOI.
• Apply to process management of DSP process.
• Apply to full inspection of Final Polishing.
• Apply to IQC and process management in FAB manufacturer.